4月24日,CIAS2025动力·能源与半导体大会在苏州顺利落幕。作为聚焦先进封装与测试、功率器件、光储、汽车电子等多产业链的年度盛会,会议汇聚来自全国的专家学者与企业代表,围绕半导体技术趋势、新能源驱动路径与智能制造突破进行深入交流,共谋发展新机遇,激发创新新动能。

在备受瞩目的“金翎奖”颁奖环节中,苏州博众半导体有限公司再次凭借硬核实力,从众多参评企业中脱颖而出,荣登优秀供应商TOP50榜单!

新质生产力驱动下,封装设备驶入“快车道
随着新能源汽车、光伏储能、光通信、工业激光等产业的高速发展,功率半导体正持续释放出巨大的技术革新需求。封装设备作为连接晶圆制造与终端应用的关键环节,正面临更高精度、更高集成、更高良率的挑战,尤其是在共晶焊接、多芯片贴装等场景中,设备的自动化、智能化程度成为行业升级的重要方向。
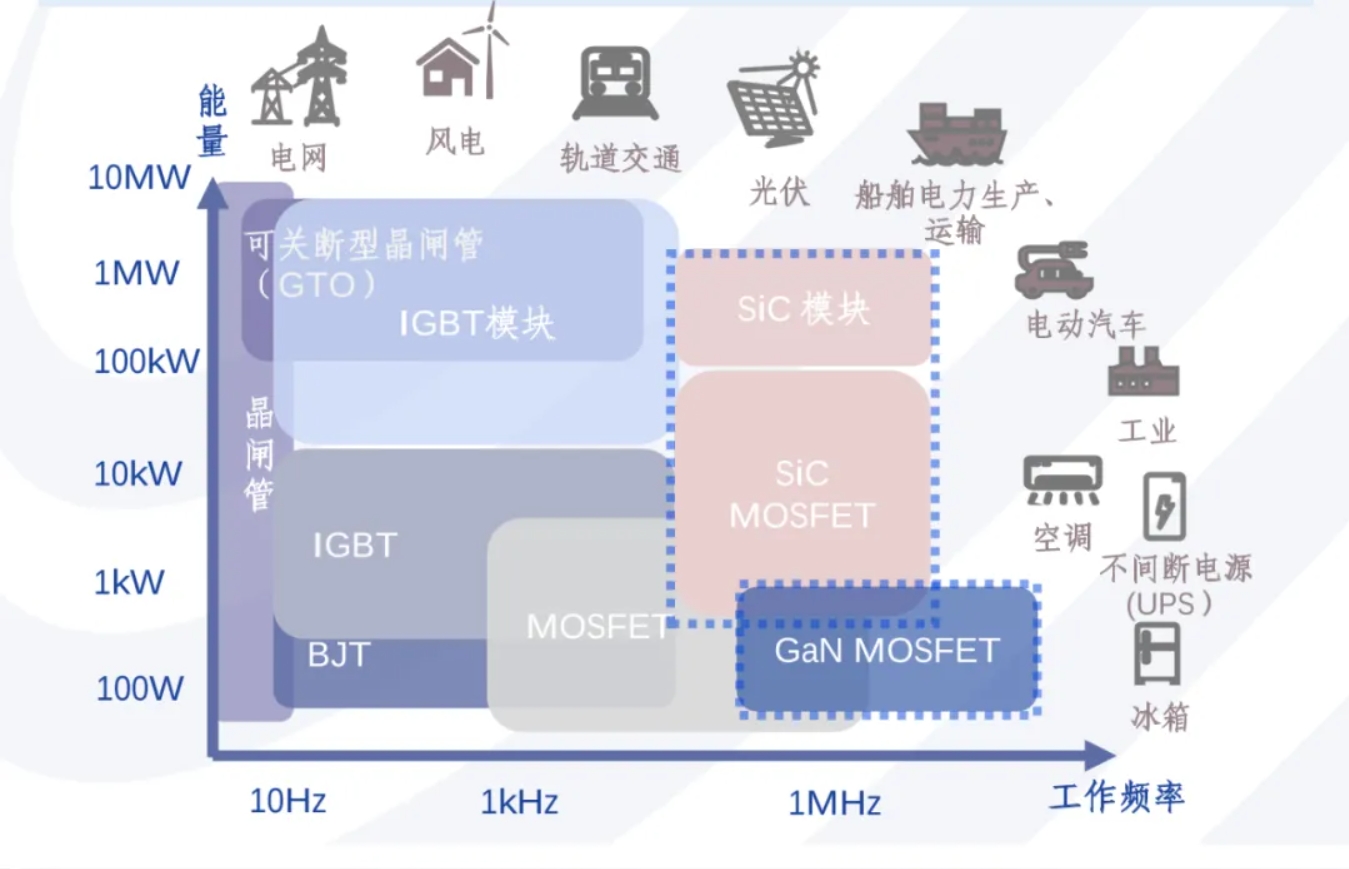
以IGBT市场为例,根据 Precedence Research 最新的研究报告,2024年全球IGBT市场规模约为74.5亿美元,预计2025年将增长至81.8亿美元,复合增长率高达9.68%。中国市场更展现出强劲势头,预计2025年市场规模将达到522亿元。面对多样化的封装需求,星驰DU9721凭借灵活适配多类封装工艺的能力,在激光器、光通信、功率模块等多个核心领域展现出强劲实力。

(数据来源:Precedence Research、Yole Group、中商产业研究院)

客户验证、市场反馈,双重实力背书
目前,博众半导体星驰系列DU9721设备已成功应用于多家激光器、光通信模块及部分功率器件客户产线的产线上,在贴装精度、热压一致性、产线稳定性方面表现优异,助力客户实现产能与良率的双提升。
设备推出以来,我们收到的每一条正向反馈,都是对技术方向的最好肯定。
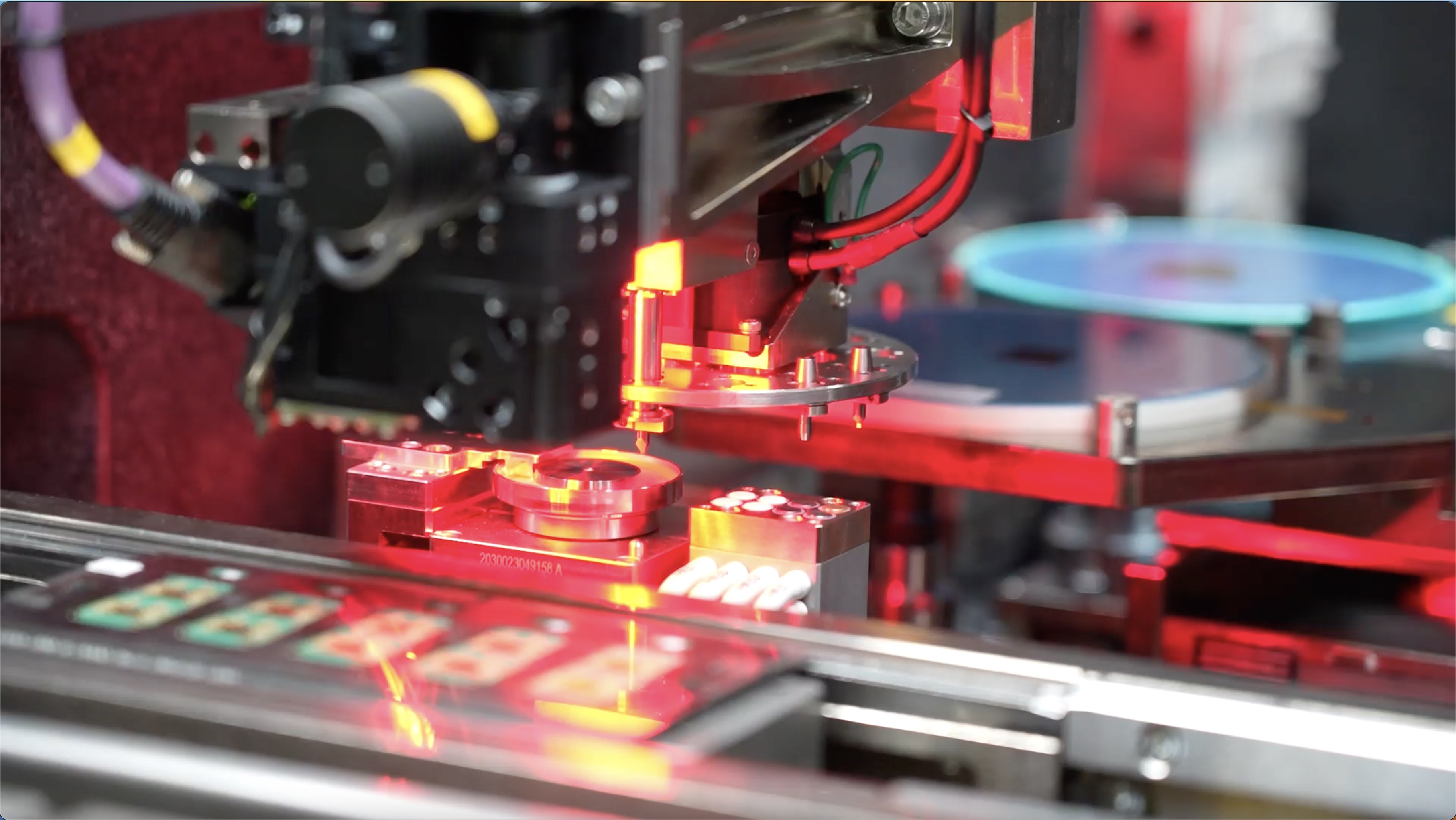
金翎”加身,是荣誉,更是新起点
此次荣获CIAS2025“金翎奖”,不仅仅是一块奖牌,更是一份来自行业的高度认可,是客户信任、团队努力与产品实力的集合回响。














